半導體
非接觸金線檢查機
- 流程:選取被測接腳 → 施加訊號 → 讀取 Sensor訊號 → 與基準訊號數據比對 → 輸出 Pass/Fail。
- 優勢:非接觸、快速掃描、可量產導入,提升終檢良率與追溯效率。
- 適用:WB BGA IC、Molding制程檢驗、密線區封裝之出貨終檢與 FA 驗證
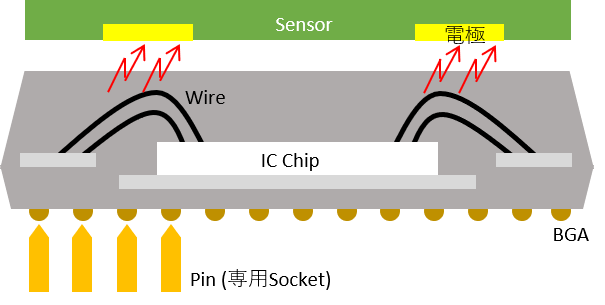
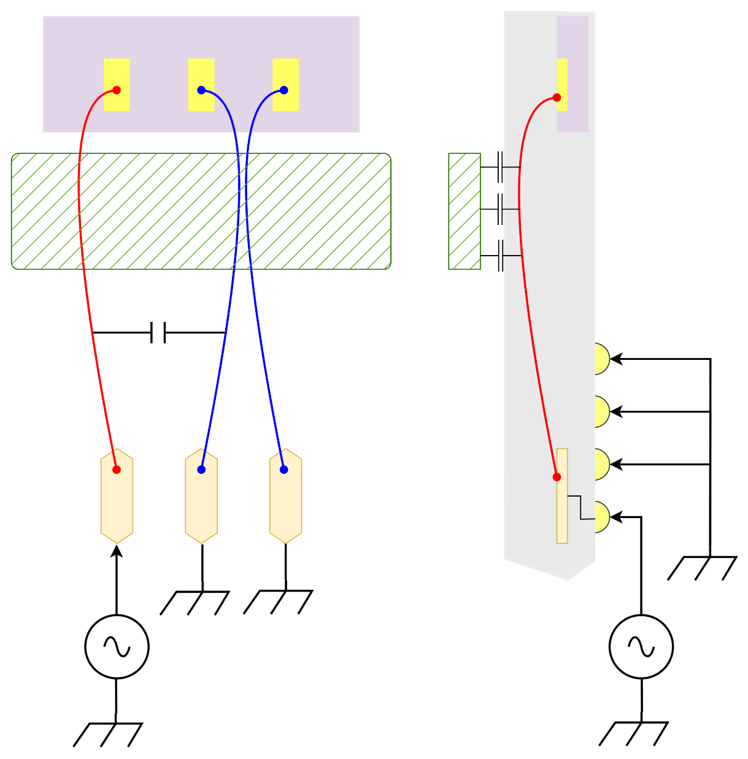
Advanced Non-Contact Bonding Wire Inspection System
Overview:
After IC molding, a capacitive-coupling sensor is used to non-contact detect bonding wire proximity (wire-close) and shorts.
Signals are input from the Ball Grid side and detected by the non-contact sensor, allowing measurements without damaging the sample.
Inspection Process:
Select the target pin → Apply signal → Read sensor signal → Compare with reference data → Output Pass/Fail judgment.
Features & Benefits:
・High-speed scanning enabled by non-contact signal detection
・Easy inline integration into production lines
・Contributes to improved yield in final inspection and more efficient traceability.
Application:
・Post-IC molding process inspection of wire-bonded (WB) BGA
・Final pre-shipment inspection after sealing high-density WB wiring areas
・Yield improvement through feedback to the process via failure analysis (FA).
